倒装芯片绑定(Flip-Chip Bonding)测试
随着集成电路封装密度提高,芯片上的引脚由四周分布变为全芯片表面分布,而对应基板上的引脚也由四周分布变为全基板分布。传统的Die bonder和Wire Bonder设备已经无法满足这种新型引脚分布的封装要求,因此倒装焊技术应运而生。但是考虑到倒装芯片基材是比较脆的硅,若在取料、助焊剂浸蘸过程中施以较大的压力容易将其压裂,同时细小的焊凸在此过程中也容易压变形,此外基于成本考虑,每秒绑定的次数为几次或几十次。所以如何在快速的生产过程中保证贴片力的精度及稳定性是半导体行业关注的重点。
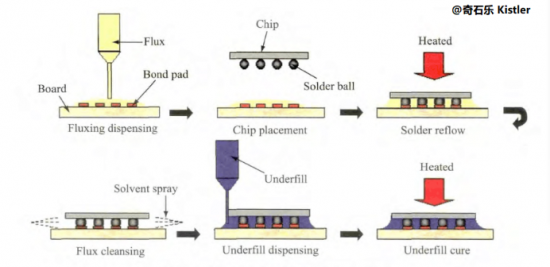
奇石乐提供倒装芯片绑定(Flip-Chip Bonding)的测试系统,结合压电式力传感器+电荷放大器可实现快速响应并执行反馈,保证生产快速稳定。
该方案有以下优势:
1. 压电传感器几乎无限的寿命,适合于大批量高频次的在线检测
2. 压电传感器具有高频响(>20KHz),可快速捕捉绑定时力值大小
3. 压电传感器多段标定且能保证精度,即可保证小力时精度,又可防过载
4. 电荷放大器具有很高的刷新速度,可快速将力值传输到监控设备,以达到实时监控的作用



